Revolutionizing Chip Packaging: COWOS Technology Takes the Lead with High Performance and Low Cost Solutions
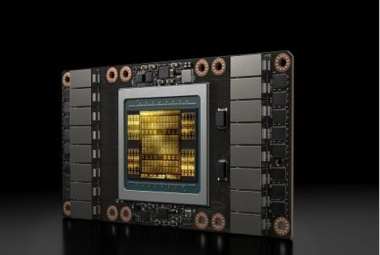
COWOS, which stands for Chip-on-Wafer-on-Substrate, is a new packaging technology that involves attaching a chip directly onto a wafer using wireless bonding, and then forming the final package structure through chemical mechanical polishing (CMP) and subsequent processing. Compared to traditional packaging technologies, COWOS offers many advantages, such as higher performance, smaller package size, higher integration, and lower packaging costs. It is widely used in high-end chip packaging fields such as GPUs, FPGAs, and ASICs.
COWOS is a high-tech packaging technology that requires complete manufacturing processes and professional equipment support. Currently, there are only a few internationally renowned companies such as Intel, Samsung, and TSMC that can partially master the manufacturing processes of COWOS technology. According to reports, Samsung first adopted COWOS technology in its Exynos 9825 chip in 2019, and plans to apply it to more chip products in the future. Companies such as Intel, TSMC, and IBM are also researching and developing COWOS technology.
Placing chips directly on wafers to produce the required devices is an important trend in chip packaging and integration. COWOS technology is one of them. Some famous electronic entrepreneurs and industry experts have expressed optimism about the prospects of COWOS technology. David Gordon, co-founder of Intel, stated that COWOS can significantly improve the integration and cost-effectiveness of chips without sacrificing their performance and reliability, and is the future direction of chip packaging and integration. Sun Chaoyang, Vice President of the International Semiconductor Technology Development Strategy Alliance (SEMI), also stated that COWOS technology will occupy an increasingly important position in future semiconductor manufacturing.




